国内最活跃的OSAT主要瞄准台积电CoWoS封装技术的替代工艺展开开发,针对晶圆级系统的3D封装方案也在积极进展,并布局到未来建厂计划中。围绕基于国内的先进工艺制程推出全国产化先进封装方案这一核心发展理念,国内封测厂出国构建了一套涵盖Chiplet产品设计仿线D封测解决方案。
超越传统OSAT模式,赋能异构集成系统生态,提供聚焦应用、针对产品的一站式芯片成品制造解决方案,将成为国内先进封装厂奋斗2025-2028年的时代使命。相关研发部署以及产线年部分产线将建成投产。
盛合晶微专注于12英寸中段硅片制造与测试服务,涵盖凸块、再布线、三维系统集成等先进封装工艺,先进封装技术平台叫做 3D SmartPoser,通过超高的垂直铜柱互连提供更强三维(3D)集成功能,3DFO是SmartPoser™技术平台衍生出的晶圆级系统集成技术,具有高密度RDL和TIV特性,可实现高密度互连,并为各种应用如移动、高性能计算等提供高性能封装方案。量产任务部署在三维多芯片集成封装项目、超高密度互联三维多芯片集成封装项目3D PKG产品19.2万片/年、形成月产能达4000片(12 英寸)的量产能力。目前,盛合晶微 2.5D集成市场市占率业内第一,3D封装业内引领。

华天科技先进封装技术平台-HMatrix覆盖了从WLP、SLP、eSinC®,其中2.5D/3D方案包含RDL Interposer、Si Interposer、3D Stack与Cu-Cu键合。bumping技术, TSV技术,C2W和W2W技术,可以实现多芯片高密度高可靠性3D异质异构集成。在eSinC晶圆上贴装芯片或两个eSinc晶圆进行堆叠,就成为了3D FO SiP封装技术,可以实现不同结构的SiP封装。而该技术与TSV和eSiFo一起,还构成了华天科技的3D Matrix晶圆封装平台。相关项目规划部署在华天先进、华天南京二期。
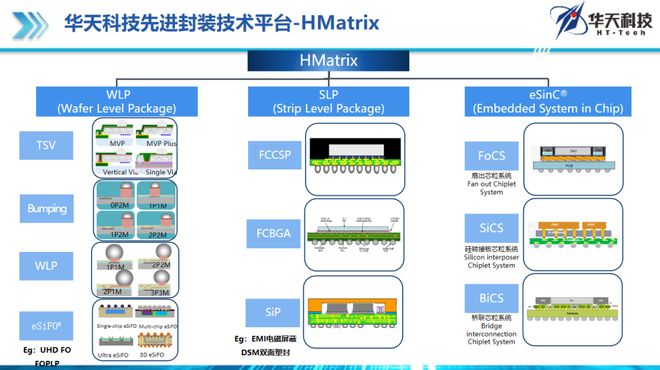
通富微电与AMD合作开发3D堆叠技术已量产,其先进封装平台VISionS强调垂直集成和高密度互连,支持多芯片封装(MCP)和Chiplet架构,提升集成度和散热能力。相关项目规划部署在通富超威(苏州)、南通通富、通富通达。

长电科技先进封装平台XDFOI是一种面向Chiplet架构的超高密度、多扇出型封装,支持2D、2.5D、3D等多种先进集成技术。线um的同时,可实现多层布线层,另外,采用了极窄节距凸块互联技术,封装尺寸大,可集成多颗芯片、高带宽内存和无源器件。相关项目规划部署在长电先进、星科金朋半导体(江阴)、长电绍兴、长电微电子。
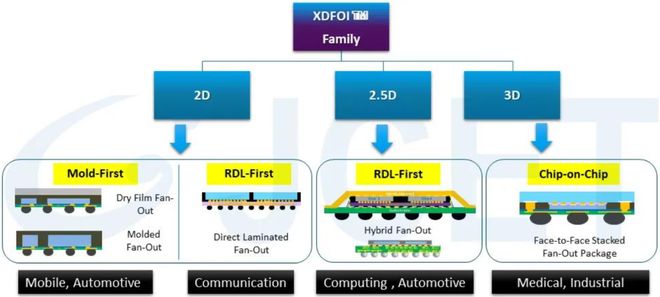
天成先进12英寸晶圆级TSV立体集成项目二期导入3D技术方案——“洞天”,以 TSV 硅通孔为核心,通过晶圆重构与堆叠实现 3D 集成。“洞天・汇” 技术支持 15:1 的 TSV 高宽比,兼容存储芯片与裸芯片,为算力芯片提供 “非先进制程” 的性能升级方案。量产年在2028—2032年期间,二期规划 60 万片 / 年。

甬矽电子积极布局先进封装领域,公司的 2.5D平台FH-BSAP正布局客户。其中Vertical系列瞄准晶圆级垂直芯片堆栈封装)涵盖VMCS& VSHDC,垂直芯片堆栈封装技术通过将芯片进行垂直堆叠(TSV / Micro bump / TCB / 混合键合等),有效缩短了芯片间的信号传输距离,提高了信号传输速度,同时降低了功耗。开发 3D 封装技术将落地在百亿级的二期晶圆级封装高密度 Chiplet项目,量产节点2028年前后。
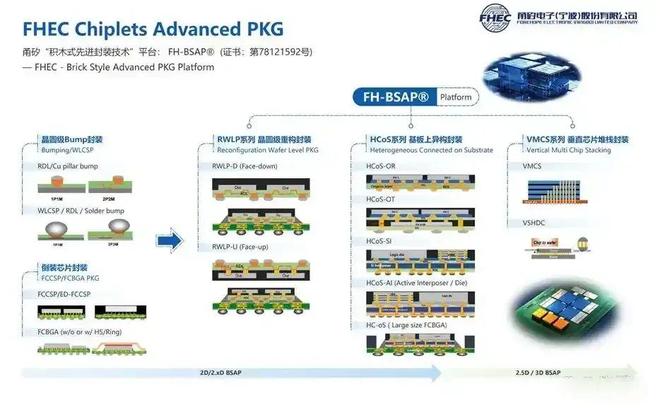
佰维存储正卡位“研发封测一体化”的独特战略卡,掌握 16 层叠 Die、30~40μm 超 薄 Die、多芯片异构集成等先进封装工艺。旗下广东芯成汉奇半导体技术有限公司具备晶圆级先进封装及 2.5D 技术能力,具有片3D堆叠封装方法及芯片3D堆叠封装结构的专利,专注于晶圆中段制造和测试,高带宽存储内存封测技术研发,提供 12 英寸晶圆凸块、再布线 万片/年,二期到2027年增加到 60 万片,直接瞄准 HBM、存算一体这些高端需求。
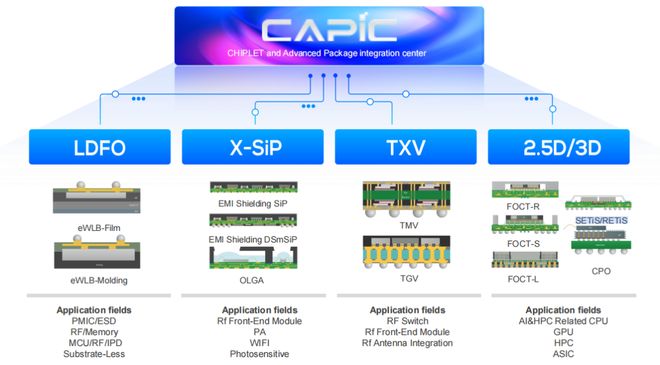
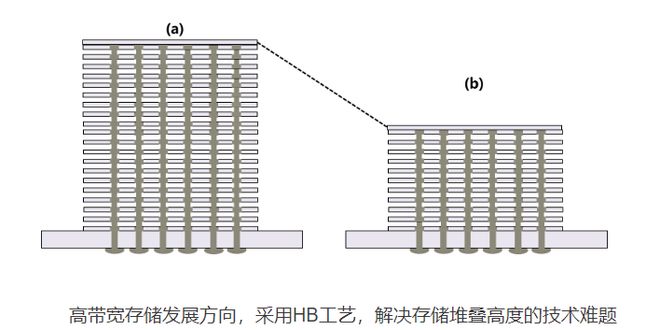
物元半导体以混合键合(Hybrid Bonding)为技术平台,专注于晶圆对晶圆(WoW)、芯片对晶圆(CoW)等异构、异质集成中道工艺的深度开发,可为客户提供一系列三维集成电路(3D-IC)、定制化IC产品及技术服务。物元具备铜铜晶圆键合的堆叠技术,根据产品的应用,可以提供F2F, F2B,1+2,1+4等多种3D晶圆堆叠工艺。
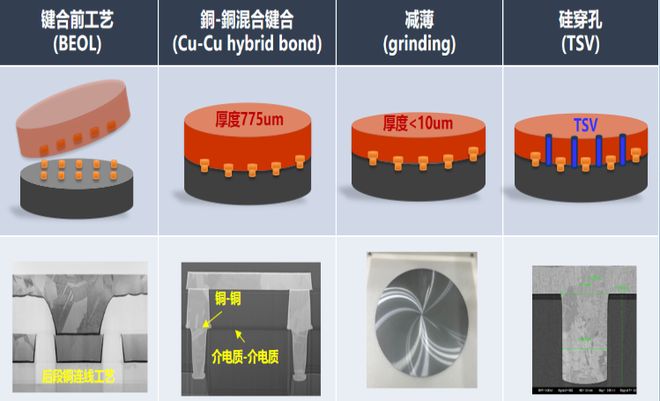
深科技国内最大DRAM封测基地,为金士顿、长江存储代工。也是长鑫存储最大的委外封测供应商。深科技已完成了16层堆叠技术的研发,并具备了量产能力。超薄POPt封装技术是一种先进的三维集成封装解决方案,通过在封装基板中形成穿透基板的通孔(TSV)实现不同层之间的电气连接,允许多层芯片垂直堆叠且封装高度较薄。凭借在高端存储芯片封测领域的优势,有望在 HBM 封装领域占据一席之地。子公司沛顿科技提供DRAM完整测试服务的企业,布局3D XPoint存储技术、超薄3D POPt封装技术。
锐杰微科技在业内较早部署了2.5D/3D技术,其最新发布的3DISTM先进封装平台由三部分组成:基于2.5D封装的ISoWoS-STM,ISoWoS-LBTM平台,基于3D封装的3D-SoWoSTM平台。这种晶上系统的超异构封装技术为算力芯片创新带来新的设计自由度。

上海易卜半导体有限公司Chiplet封装技术平台COORS, 包括COORS-R 和 COORS-V(硅桥);晶圆扇出,2.5/3D硅转接板、中道凸块,相关产能部署在上海宝山工厂。
晶通科技用于芯粒集成的嵌入式扇出硅桥封装方案解析MST Fobic 用Bridge Si技术,实现了亚微米级别的互联;而TMV技术使得晶通硅桥Chiplet能够实现2.5D/3D互联。2.5D/3D封装技术从研发到量产落地在二期产能
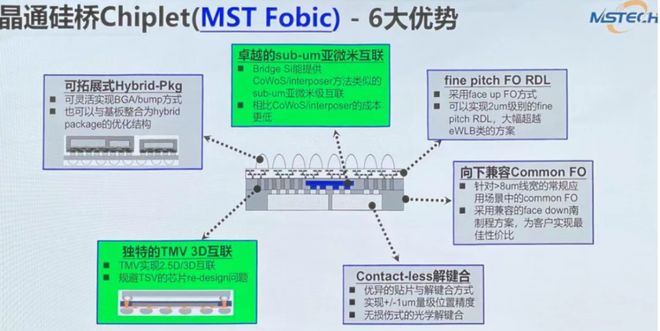
大港股份产品主要集中在凸晶(点) /微凸点(Bumping/Micro-Bumping/Gold Bump ) 、 晶圆级芯片封装、扇出型封装、三维堆叠与系统集成封装 (3D Packaging & SiP)。旗下苏州科阳半导体有限公司具备2.5/3D集成全尺寸晶圆级封装产品线,相关项目在苏州建设的集成电路12吋TSV及车规CIS暨RF滤波器3D先进封装项目。
广东越海集成技术有限公司专注TSV技术、晶圆级封装及异质异构集成技术,公司2.5D/3DTSV先进封装项目基础配套设施项目建设已经启动,项目是作为落地广州的“晶圆级先进封装”项目。
艾司博瑞芯成(青岛)科技有限公司储备3D晶圆级封装技术,其3D TSV 优势在于在单位体积内集成更多芯片(如HBM内存+逻辑芯片堆叠),封装密度提升2-3倍,适用于AI芯片、高性能计算等对空间敏感的场景。部署在12英寸晶圆封装测试二期国际先进的封装测试技术。
紫光宏茂已发展成为提供全系列存储器封测的一站式服务供应商,全新3D NAND封装测试产线建设为紫光存储提供了企业级SSD所需的3D NAND芯片颗粒。其产品涵盖3D NAND、2D NAND、NOR、DRAM、SRAM等多种存储器产品的封装与测试。
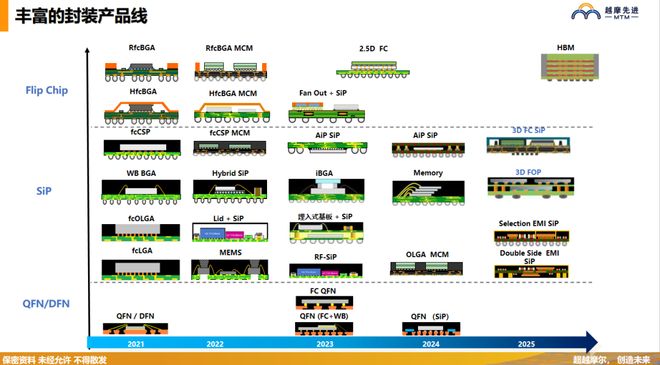
湖南越摩先进以SiP和Chiplet为核心,在高密度封装领域形成显著竞争力。其散热技术专利与仿线D技术发展提供支撑。随着AI/5G芯片需求增长,公司有望通过技术迭代向更复杂的3D集成延伸。目前已有3D Chiplet GPU、HPC产品成功出货。
江苏中科智芯集成科技有限公司前瞻性布局战略,对2.5D/3D堆叠等尖端封装技术深入钻研,储备混合键合技术。公司先进封装平台下三维堆叠与系统集成封装囊3D Packaging & SiP相关产能部署在12 寸晶圆的扇出型先进封装生产线二期待建。
东莞锐信仪器有限公司明确布局 2.5D/3D先进封装技术,聚焦 CSP、SiP、FCBGA、FOWLP 等高端工艺,服务于AI、高性能计算、智能汽车等领域 。核心目标是提供系统级封装测试整体解决方案,支持高密度集成需求 。后续将在覆盖晶圆凸块、扇出封装量产级生产线D封装,瞄准高性能计算芯片的垂直堆叠。
北京芯力技术创新中心有限公司除了芯力2.5DColoS先进封装工艺平台,还建设了面向高性能计算、人工智能的12吋先进封装重视平台,规划了3D异质异构集成封装能力。
华进半导体封装先导技术研发中心有限公司拥有完整面向Chiplet先进封装设计能力,可以为人工智能、高性能计算领域的客户提供2.5D到3D的Chiplet集成服务。其晶圆级芯片结构多芯片堆叠互连结构及制备方法克服了现有技术中在3D芯片封装或晶圆级封装时的难题,相关产能落地在华进半导体三维异质异构系统集成(三期)。
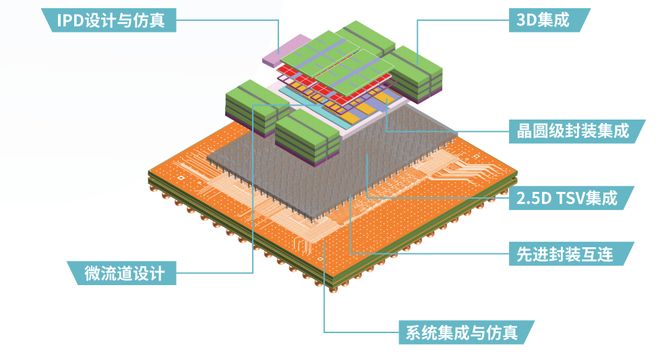
佛山市星通半导体有限公司储备相关技术,项目二期将进一步拓展至行业前沿技术,包括凸块(Bumping)、硅通孔(TSV)、Chiplet、2.5D/3D封装技术。相关项目总投资约45亿项目建成后,工艺水平将位居国内第一梯队,将成为大湾区规模最大的芯片测试封装基地。
芯核集群(杭州)科技有限公司据悉已签约在萧山经开区落地算力服务器先进封装项目,项目总投资约60亿元。项目以构建“虚拟IDM大厂”为目标,深度整合半导体先进封装产业链,通过SiP(系统级封装)和2.5D/3D封装技术,突破高端制程限制,开发自主AI芯片及服务器解决方案。
半导体封测()行业媒体是产业全链条的信息枢纽,聚焦芯片设计、制造、封测等核心环节。追踪英特尔、台积电、中芯国际等全球巨头动态,解析光刻、EDA、先进制程等关键技术突破与瓶颈。实时播报行业规模、市场格局变迁,如全球半导体市场规模波动、区域竞争态势。同步传递政策风向、资本动向,为从业者提供技术迭代、市场布局的精准参考,打通产业信息壁垒。

